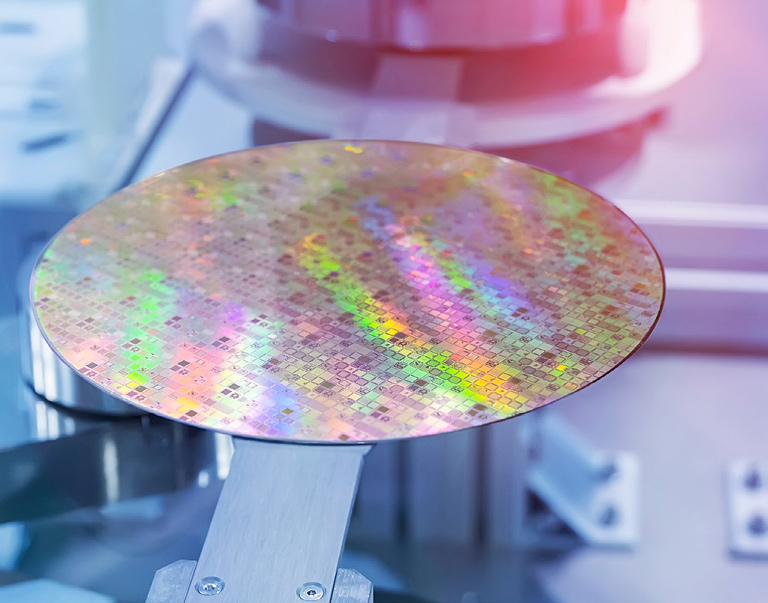
半導体産業におけるウエハーのインライン品質管理
ウエハー計測用 CHRocodile センサー
半導体および超小型電子検査センサーは、ウエハーのゲージを測定し、スクリーン製造における構造を判別し、インライン品質管理中に接合をチェックする必要があります。さらに、透明コーティングを測定し、品質管理のために機械的および化学的除去プロセスをリアルタイムでモニタリングする必要もあります。
μmレンジの横方向の分解能とサブμmレンジの高い分解能を備えた当社の CHRocodile センサーは、これらの要件をすべて満たし、過酷な産業環境とクリーンルーム環境の両方で信頼性の高い測定を実現します。
Precitecのセンサーポートフォリオを補完するEnovasenseセンサーは、レーザ光熱技術を使用して、不透明および半透明のコーティングの厚さを測定します。
不透明な層厚の測定
半導体産業でのウエハの加工には、ハードマスク層、メタライズ層、バックパック層、コア半導体層、誘電体層など、さまざまなコーティングや層が関係しています。光学技術や放射技術では、不透明な層の測定には限界があります。
それとは対照的に、Enovasense のレーザ光熱技術は、非接触、非破壊、非侵入、非放射、高速かつ再現性の高い測定であり、広範囲の不透明なコーティングの厚さを測定できます。
で紹介しています。詳細な情報は、フォームにご記入の上、ダウンロードできます。
ウエハーの薄化と構造化中の工程内の厚さモニタリング
かつてなく低い総厚さのばらつき (TTV) であるか、または定義された構造化表面を持つウエハーの需要が高まるにつれ、非接触、非破壊測定技術による、非常に正確な工程内の厚さモニタリングが不可欠になりました。
課題は、幅広いウエハーの厚さの範囲、さまざまなプライムウエハー材料、および過酷なインラインプロセス環境 (例えば研削スラッジのためにウエハーがはっきりと見えないなど) から生じます。当社のCHRocodile 2 IT, IT DW シリーズ および 2 DPS センサーは、大きく変動するウエハーの厚さおよび材料 (Si ドープ、高ドープ、SIC、GaN、InP、プラスチック、サファイア、LiTaO) およびウエハー加工状態を、信頼できる仕方で測定できます。
耐水性および耐酸性のプローブとウォータージェットプローブは、摩耗による影響を受けないため、運用コストを削減できます。また、異なるプロセスマシンへのカスタマイズされた組込みにも適しています。
光学測定によるウェーハ厚みの精密なモニタリングと制御については、英文ホワイトペーパー「CMP and grinding in semiconductor industry」で紹介しています。詳細な情報は、フォームにご記入の上、ダウンロードできます。
ウエハーのたわみ、反り、TTV のモニタリング
ウエハーのたわみ、反り、または TTV が大きすぎると、ウエハーの取り扱いと加工に大きな課題が生じ、ウエハーの破損や重大な生産ロスを引き起こす可能性さえあります。不良品を最小限に抑えるためのこれらの値の測定は、高度に正確かつ高速であるだけでなく、非破壊的、つまり非接触である必要があります。たわみと反りは製造ステップが異なると変化するため、計測とプロセスのフィードバックは重要です。
当社の非接触光学測定技術により、たわみや反りが発生する製造ステップに近い工程内配備が可能になります。CHRocodile 2 IT および CHRocodile 2 DPS センサーは柔軟なソリューションを提供し、コンパクトな色収差プローブを備え、簡単に再取り付けでき、あらゆる種類のウエハーの測定に対応します。
ダイシング溝の検査
材料処理中または材料処理後にダイシング溝の深さと幅をモニタリングすることで、必要な処理品質を保護できます。溝を視覚化すると、ダイの破損や高額な出力損失につながる可能性があるダイクラックも明らかになります。溝の深さと幅を測定することで、標準からの逸脱があれば、ウエハーを再加工できます。
溝の部分をできる限り最大に画像化し、できるだけ多くのダイクラックを特定するには、横方向の分解能が高く、精度の高い高速非接触計測が必要です。CHRocodile CLS は、ダイシング溝の深さと幅の測定に適しています。
幅のみを測定する必要がある場合は、高速測定が可能な Chromatic Vision Camera (CVC) をお勧めします。
どちらのデバイスも優れたイメージング品質を備えており、サンプルに対して垂直な角度で測定するため、シャドウイングの影響を受けません。さらに、高さ測定は非常に正確で、横方向の分解能は非常に高く、傾斜のある斜面でも測定が可能です。
はんだバンプの測定と検査
電気的な接続には、ウエハーレベルのバンプとはんだバンプが不可欠です。それらの高さとコプラナリティを測定することで、接続の品質を保護します。バンプ間隔が減少し、バンプ密度が増加するため、トポグラフィーを正確かつ十分に高速に測定できるのは、同軸イメージングのみです。
CHRocodile CLS はこのテクノロジーを使用して、優れた精度と分解能の測定を行います。さらに、同軸イメージング技術はサンプルに対して垂直な角度で測定するため、狭い間隔や傾斜のある斜面でも正確なバンプ形状を測定できます。
ダイクラックの検出
ダイシング中の材料処理は、ウエハーにストレスを与え、シリコンが割れることがあります ダイシンググルーブを視覚化すると、後工程でダイが破損する可能性のあるシリコンクラックを検出することができます。ウエハーが薄ければ薄いほど破損のリスクは高くなり、これらの微細なクラックを検出することはさらに重要になります。
Chromatic Vision Camera (CVC) は、高分解能と高被写界深度を組み合わせて、オートフォーカスを必要とせずにシャープなイメージングを確保します。CVC のライン高速スキャン速度により、検査時間を短縮し、スループットを向上させます。
ウエハーとフォトマスクの位置合わせ
フォトリソグラフィーでは、マスクとウエハーの µm 精度の調整が不可欠です。構造が小さいほど、横方向と平行方向の位置合わせはより正確でなければなりません。これらの要件を満たすには、非常に正確な非接触測定が必要です。
CHRocodile 2 S の色収差共焦点および干渉検出器は、これらの要件を満たし、半導体業界の複数のレベリングアプリケーションにも適しています。さらに、センサーはメンテナンスフリーであり、製造環境でのノンストップオペレーション向けに設計されています。
ダイとウエハーのボンディング
ダイとウエハーのボンディングは、ボンディングと IC パッケージの小型化を可能にし、チップのエネルギー消費量も削減するため、従来のボンディング手法に取って代わりつつあります。ただし、IO 接続を確保するには、ダイまたはウエハーの高精度な位置合わせが不可欠です。
プレシテック CHRocodile 2 S, CLS, 2 IT の光学センサーと Chromatic Vision Camera CVC は、ダイの正確な位置、高さ、傾き、回転を測定し、ボンディング中に正確なウエハー配置を可能にします。色収差共焦点センサーと干渉センサーの優れた精度により、最適なボンディング結果が保証されます。
さらに、測定速度が速いため、工程内検査が可能になり、スループットが向上します。また、製造プロセスから欠陥のある接合を取り除くことができます。
プローブカードの検査
プローブカードは一般に、完成したウエハーの回路テストを行うために使用されます。プローブカードには、ウエハー上の各ダイに個別に接触してテスト信号を印加する多数の小さなチップがあります。チップの高さの均一性と横方向の位置は、最適なウエハーテスト結果を保証するために、定期的に検査する必要があります。各プローブカードには何千もの密に詰められたチップがあり、高速、同軸、そして何よりも非接触計測が必要です。
CHRocodile CLS ラインセンサーと CHRomatic Vision Camera の色収差共焦点技術により、横方向と軸方向の精度が非常に高く、高速で信頼性の高い検査が保証されます。