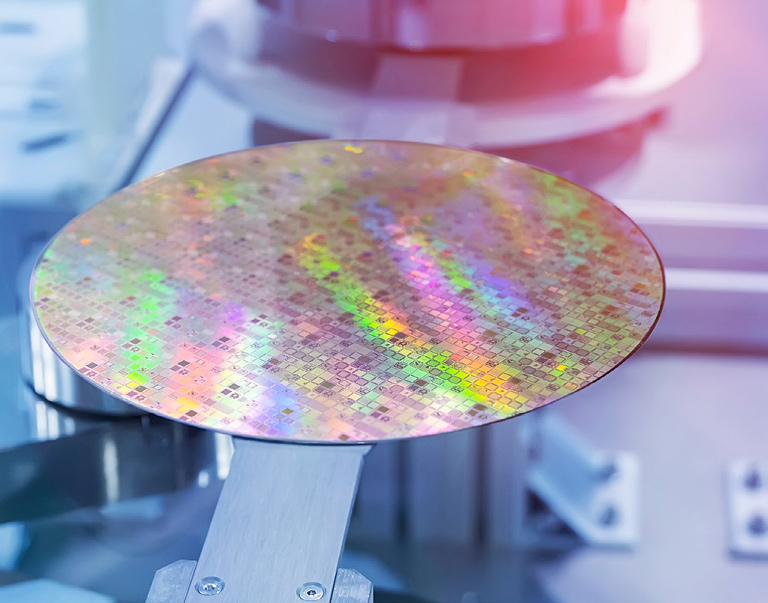
半導體產業中晶圓的線上品質控制
用於晶圓計量的 CHRocodile 感測器
半導體和微電子檢測感測器需要測量晶圓的規格,確定螢幕製造中的配置情況,並線上品質控制過程中檢查接合情況,此外,還必須測量透明塗層,並實時監測機械和化學去除過程,以進行品質控制。
憑藉微米範圍內的橫向解析度和亞微米範圍內的高解析度,我公司研發的 CHRocodile 感測器滿足了上述所有要求,並可在惡劣的工業環境或潔淨室環境中提供可靠的測量。
Enovasense 傳感器補充了 Precitec 的傳感器產品,後者使用激光光熱技術測量不透明和半透明塗層的厚度。
晶圓薄化和結構化期間的製程中厚度監測
隨著晶圓的總厚度變化(TTV) 越來越低、對特定結構表面的要求越來越高,極精確製程厚度監測採用的非接觸式和非破壞性測量技術已經成為不可或缺的測量方案。
不同的晶圓厚度範圍、不同的晶圓原材料以及苛刻的線上製程環境(例如,由於研磨液而無法清楚地看到晶圓)均是測量技術的挑戰。我公司研發的 CHRocodile 2 IT、IT DW 系列 和 2 DPS 感測器能夠可靠地測量各種晶圓厚度和材料(摻雜矽、高度摻雜、碳化矽、氮化鎵、磷化銦、塑膠、藍寶石、鉭酸鋰)以及晶圓加工狀態。
防水耐酸探頭和噴水探頭抗磨損,因此降低了運作成本,也可以將這類探頭透過客製化方式整合到不同的製程機械中。
我們的英文白皮書“半導體工業中的 CMP 和研磨”中描述了透過光學測量對晶圓厚度進行精確監測和控制。詳細資訊可以通過填寫表格下載。
監測晶圓彎曲度、翹曲度和總厚度變化
晶圓彎曲度、翹曲度或總厚度變化過大是晶圓處理和加工面臨的巨大挑戰,甚至會導致晶圓破裂和嚴重的生產損失。為了將損失降至最低,必須進行高精度和快速測量,同時確保測量過程不會造成破壞,即非接觸式測量。在不同的生產步驟中,彎曲度和翹曲度會發生變化,因此計量和過程反饋至關重要。
我公司研發的非接觸式光學測量技術能夠部署在生產線附近,實施製程測量,從而避免晶圓彎曲和翹曲。CHRocodile 2 IT 和 2 DPS 感測器使用靈活,配有緊湊的彩色探頭,易於改裝,可測量各種晶圓。
切割槽檢測
在材料處理期間或之後監測切割槽的深度和寬度可以保證所需的處理品質。同時還應檢測切割槽,確認是否有晶粒裂痕,否則可能導致晶粒破損和高昂的產量損失。切割槽深度和寬度的測量可以確保晶圓一旦偏離規範就進行重工。
為了將切割槽的最大部分成像,並儘可能多地發現晶粒裂痕,必須採用高橫向解析度和高精度的測量工具進行快速非接觸式測量。CHRocodile CLS 非常適合測量切割槽的深度和寬度。
如僅需測量寬度,我們公司研發的彩色視覺相機 (CVC)是高速測量的不二選擇。
這兩種裝置的成像品質都非常出色,並且與樣品呈直角測量時也無陰影。此外,高度測量非常精確,橫向解析度非常高,可以測量坡度非常大的樣品。
測量和檢查焊接凸點
晶圓級凸點和焊接凸點對於電子互連非常重要,測量這些凸點的高度和共面性可保證互連品質。隨著凸點間距的減小和凸點密度的增加,只有同軸成像才能足夠精確和快速地測量形貌。
CHRocodile CLS 利用同軸成像技術實現高精度、高解析度的測量。此外,同軸成像技術以垂直於樣品的角度進行測量,因此,即使在間距很低且角度很大時,也能精確測量凸點形狀。
晶粒裂痕檢測
切割過程中的材料處理會對晶圓施加壓力,矽片可能會破裂。視覺化切割槽可檢測此類矽片裂痕,否則可能在後續生產過程中導致晶粒破裂。晶圓越薄,破裂的風險就越高,檢測這些微小的裂痕就越重要。
彩色視覺相機 (CVC) 將高解析度與高景深相結合,確保清晰成像,無需自動對焦。因此,CVC 的快速線掃描節省了寶貴的時間並提高了產量。
晶圓和光罩對準
在光刻過程中,光罩和晶圓的精確對準至關重要,結構尺寸越小,橫向和平行對準必須越精確。為了滿足這些要求,必須進行高度精確的非接觸式測量,
CHRocodile 2 S 的彩色共焦和干涉探測器可滿足這些要求,也適用於半導體行業的多層水平測量應用。此外,這類感測器無需維護,在生產環境中可實現不間斷運轉。
晶粒和晶圓鍵合
晶粒和晶圓鍵合越來越多地取代了傳統的鍵合技術,因為這種鍵合方式的鍵合部分更小,且可實現積體電路 (IC) 封裝,並且還降低了晶圓的能耗。但晶粒或晶圓的高精度對準對於確保輸入輸出連線的正確性至關重要。
Precitecs CHRocodile 2 S、 CLS、2 IT 光學感測器和彩色視覺相機 CVC 可測量晶粒的精確位置、高度、傾斜度和旋轉度,並在鍵合過程中實現精確的晶圓對準。彩色共焦和干涉感測器的高精度效能保證了最佳的鍵合效果。
此外,速度測量也可以在生產過程中執行檢測,因此提高了產量,且可在生產過程中去除有缺陷的鍵合片。
探針卡檢測
通常採用探針卡在成品晶圓上進行電路測試。探針卡上有許多微小的尖端,分別接觸晶圓上的每個晶粒,並且發出測試訊號。這些尖端的高度均勻性和橫向位置必須定期檢測,以確保最佳的晶圓測試結果。每個探針卡上有數千個緊密封裝的針尖,因此需要快速同軸測量,最重要的是要保證非接觸式計量。
CHRocodile CLS 線感測器和 CHRomatic Vision Camera 視覺相機中的彩色共焦技術可確保快速可靠的檢測,並具有極高的橫向和軸向精度。