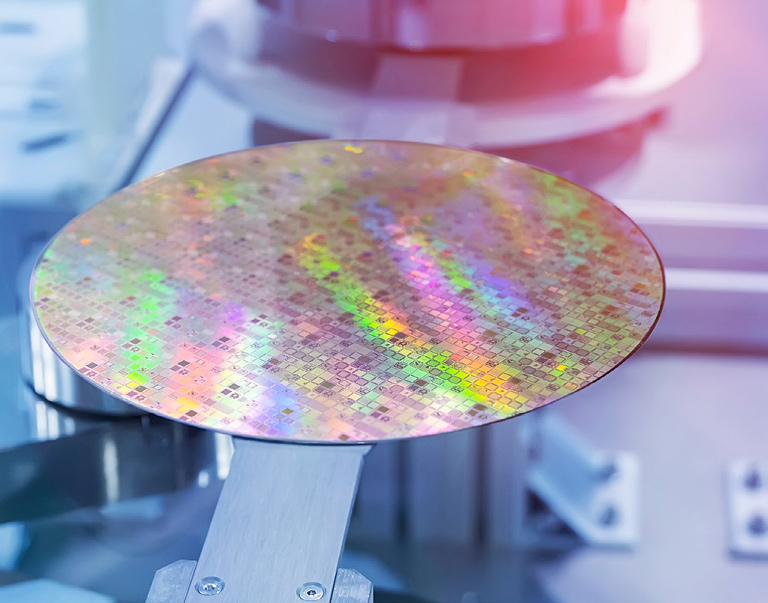
Controllo di qualità online di wafer nell'industria dei semiconduttori
Sensori CHRocodile per la metrologia wafer
I sensori di ispezione di semiconduttori e di microelettronica devono misurare lo spessore dei wafer, determinare le strutture nella produzione di schermi e controllare il bonding durante i controlli di qualità online. Inoltre, devono anche misurare i rivestimenti trasparenti e monitorare in tempo reale i processi di rimozione meccanica e chimica ai fini del controllo di qualità.
Grazie alla risoluzione laterale nella gamma dei micrometri e alla risoluzione elevata nella gamma dei sub-micrometri, i nostri sensori CHRocodile soddisfano tutti questi requisiti e forniscono misurazioni affidabili sia in ambienti industriali difficili che in camera bianca.
I sensori Enovasense, che completano la gamma di sensori di Precitec utilizzano la tecnologia fototermica laser per misurare lo spessore di rivestimenti opachi e semitrasparenti.
Misurazione dello spessore dello strato opaco
Per la lavorazione di wafer nell'industria dei semiconduttori si utilizza un'ampia varietà di rivestimenti e strati, quali ad es. strati hard mask, strati di metallizzazione, strati posteriori, substrati e strati dielettrici. Le tecnologie ottiche (inclusi i raggi X) presentano dei limiti nella misurazione di strati opachi.
La tecnologia laser fototermica di Enovasense consente invece misurazioni senza contatto, non distruttive, non intrusive, non radianti, rapide e ripetibili di un'ampia gamma di spessori di strati opachi.
Informazioni dettagliate possono essere scaricate compilando il modulo.
Monitoraggio dello spessore in-process durante l'affilatura e la strutturazione del wafer
Con l'aumento della richiesta di wafer con variazione di spessore totale (TTV) sempre più bassa o superficie strutturata definita, sta diventando indispensabile un monitoraggio estremamente accurato dello spessore in-process attraverso una tecnologia di misurazione senza contatto e non distruttiva.
Le sfide derivano dalle diverse gamme di spessore dei wafer, dalle diverse materie prime dei wafer e dal difficile ambiente di processo online (ad esempio, visione non chiara del wafer a causa del fango abrasivo). I nostri sensori delle serie di CHRocodile 2 IT, IT DW e il 2 DPS misurano in modo affidabile i diversi spessori, materiali (drogati di Si, altamente drogati, SIC, GaN, InP, plastica, zaffiro, LiTaO) e stati di lavorazione dei wafer.
Le sonde resistenti all'acqua e agli acidi e le sonde a getto d'acqua non sono influenzate dall'usura, riducendo quindi i costi operativi. Inoltre, sono adatti all'integrazione personalizzata in varie macchine di processo.
Mel nostro Whitepaper in lingua inglese "CMP and grinding in the semiconductor industry" viene descritto il monitoraggio ed il controllo di precisione dello spessore dei wafer tramite misurazione ottica. Informazioni dettagliate possono essere scaricate compilando il modulo.
Monitoraggio bow del wafer, warp e TTV
Bow di wafer e warp o TTV troppo grandi rappresentano un'enorme sfida per la gestione e la lavorazione dei wafer e possono anche causare la rottura dei wafer nonché importanti perdite di produzione. La misurazione di questi valori per minimizzare le perdite deve essere non solo molto accurata e veloce, ma anche non distruttiva, cioè senza contatto. Poiché il bow e il warp cambiano in diverse fasi produttive, la metrologia e il feedback di processo sono decisivi.
La nostra metrologia ottica senza contatto consente l'impiego in-process in prossimità delle fasi di produzione in cui si generano il bow e il warp. I sensori CHRocodile 2 IT e CHRocodile 2 DPS offrono soluzioni flessibili, con sonde cromatiche compatte, facile riarmo e misurazione di tutti i tipi di wafer.
Ispezione delle strie nel dicing
Con il monitoraggio della profondità e della larghezza delle strie nel dicing durante o dopo il trattamento del materiale viene garantita la qualità di trattamento richiesta. La visualizzazione della stria indica anche eventuali spaccature nel silicio che possono portare alla rottura del silicio stesso e a costose perdite di produzione. La misurazione della profondità e della larghezza della stria consente di rilavorare il wafer nel caso si verificassero eventuali scostamenti dalle indicazioni.
Per visualizzare la parte più ampia possibile della stria e identificare il maggior numero possibile di spaccature, è richiesta una metrologia veloce senza contatto con un'alta risoluzione laterale ed elevata precisione. I CHRocodile CLS HS sono indicati per la misurazione della profondità e la larghezza delle strie nel dicing.
Se è necessario misurare solo la larghezza, la nostra Fotocamera di visione cromatica (CVC) è l'opzione migliore grazie alla sua velocità elevata.
Entrambi i dispositivi dispongono di una qualità d'immagine eccezionale e non risentono dell'ombreggiatura, poiché effettuano la misurazione su un angolo perpendicolare al campione. Inoltre, le misurazioni dell'altezza sono estremamente accurate, la risoluzione laterale è molto elevata e sono possibili misurazioni su angolari ampi.
Misurazione e ispezione di solder bumps
Level bumps e solder bumps sui wafer sono essenziali per le interconnessioni elettroniche. La misurazione della loro altezza e complanarità garantisce la qualità dell'interconnessione. Con la riduzione della spaziatura e l'aumento della densità dei bump, solo l'imaging coassiale può misurare le topografie in modo sufficientemente preciso e veloce.
CHRocodile CLS utilizza questa tecnologia per misurazioni di grande precisione e risoluzione. Inoltre, la tecnologia di imaging coassiale effettua la misurazione ad un angolo perpendicolare al campione e può così misurare la forma precisa del bump sia a spaziatura ridotta che su angolari ampi.
Rilevazione delle spaccature nel die
Il trattamento del materiale durante il dicing comporta una sollecitazione al wafer con conseguente spaccatura del silicio. La visualizzazione delle strie nel dicing rileva tali spaccature nel silicio, che potrebbero causare la spaccatura del die durante la successiva produzione. Più sottile è il wafer, maggiore è il rischio di spaccatura, e più importante è rilevare queste spaccature microscopiche.
La Fotocamera di visione cromatica (CVC) unisce un'alta risoluzione ad una profondità di campo elevata per garantire un imaging nitido senza dover eseguire la messa a fuoco. La velocità di scansione rapida delle righe della CVC consente quindi di risparmiare tempo prezioso e di aumentare la produttività.
Allineamento di wafer e fotomaschera
Durante la fotolitografia è essenziale un allineamento preciso al µm tra la maschera e il wafer. Più ridotte sono le strutture, più preciso deve essere l'allineamento laterale e parallelo. Per soddisfare questi requisiti, sono necessarie misure molto accurate e senza contatto.
I rivelatori cromatici confocali e interferometrici nel CHRocodile 2 S soddisfano questi requisiti e sono adatti anche per applicazioni di allineamento multiplo nell'industria dei semiconduttori. Ma ciò che è più importante, i sensori non richiedono manutenzione e sono progettati per il ciclo continuo in un ambiente produttivo.
Bonding di die e di wafer
Il bonding di die e di wafer sostituisce sempre più spesso le tecniche tradizionali di bonding, in quanto consente di realizzare bonding più ridotti e pacchetti di circuiti integrati, riducendo anche il consumo di energia del chip. Tuttavia, per garantire la connettività I/O, l'allineamento molto accurato dei die o dei wafer è fondamentale.
I sensori ottici CHRocodile 2 S, CLS 2, 2 IT di Precitec e la Fotocamera di visione cromatica CVC eseguono la misurazione precisa della posizione, dell'altezza, dell'inclinazione e della rotazione dei die e consentono un allineamento preciso del wafer durante il bonding. L'elevata precisione dei sensori cromatici confocali e interferometrici garantisce risultati di bonding ottimali.
Inoltre, la velocità di misurazione consente un'ispezione in-process che aumenta la produttività, così come la capacità di rimuovere i bonding difettosi dal processo produttivo.
Ispezione delle schede di controllo
Le schede di controllo sono comunemente utilizzate per condurre test di circuito su wafer finiti. Le schede di controllo dispongono di numerose micropunte (tips) che singolarmente contattano ogni die sul wafer e applicano un segnale di prova. L'uniformità dell'altezza e la posizione laterale delle micropunte devono essere ispezionate regolarmente per garantire risultati ottimali del test dei wafer. Con migliaia di micropunte strettamente adiacenti su ciascuna scheda di controllo, è necessaria una metrologia veloce, coassiale e soprattutto senza contatto.
La tecnologia cromatica confocale dei sensori di linea CHRocodile CLS e la Fotocamera di visione cromatica garantiscono un’ispezione veloce ed affidabile con una precisione laterale e assiale estremamente elevata.